航天產品的質量和壽命取決於產品設計、研製生產和試驗測試全流程的可靠性,而積體電路安全可靠是航天電子系統在軌穩定工作的基礎。現代積體電路製造流程中,工藝製造和設計環節均可引入晶片缺陷,在使用過程中可導致失效等。隨著晶片整合度的提高,晶片正面的金屬互連層不斷增加,倒封裝工藝得到廣泛應用,從晶片正面定位缺陷位置變得愈發困難。目前,利用鐳射從背部開封裝的晶片進行的非接觸式無損缺陷定位技術,在積體電路靜態/動態缺陷定位領域得到廣泛應用。熱鐳射定位(TLS)和電光頻率對映(EOFM)是兩種典型的非接觸式缺陷定位技術。TLS利用鐳射熱效應對半導體器件材料進行區域性加熱,改變其電阻特性,實現靜態缺陷定位。EOFM利用器件內部處於不同動態工作狀態電晶體與入射鐳射的電光調製效應,透過接收反射光訊號對電路進行頻域影象分析,實現動態缺陷定位。隨著積體電路工藝的飛速進步,對缺陷分析定位的速度和靈敏度要求不斷提升,相應的TLS和EOFM理論模型和技術手段需要不斷最佳化發展,亟須發展該領域自主可控的測試裝置。
中國科學院國家空間科學中心複雜航天系統電子資訊科技院重點實驗室空間環境效應研究室致力於鐳射與積體電路相互作用機制和試驗測試技術研究。2006年,空間中心自主研製了國內首臺單粒子效應納秒脈衝鐳射模擬裝置;其後,研製了皮秒脈衝和飛秒脈衝鐳射單粒子效應試驗裝置,其效能和功能引數均已達到國際先進水平。在此研究基礎上,研究團隊針對TLS研究提出了全新的綜合理論模型,並依據此模型自主搭建了鐳射熱激發定位積體電路缺陷裝備,定位精度為0.5μm。圖1是鐳射熱激發缺陷定位裝備原理結構圖,圖2是利用自主研發的鐳射熱激發缺陷定位裝備對一款微控制器晶片的故障點定位結果。相關研究成果發表在Applied Sciences上。
在傳統的EOFM技術基礎上,科研團隊提出了一種新的基於同軸顯微鏡的定位積體電路內部功能單元的頻率對映方法,自主搭建了積體電路缺陷檢測電光探針測試裝備,如圖3所示。目標電路以設定工作頻率工作,透過分析反射鐳射的頻率特性,準確定位目標電路功能區域及可能的缺陷位置。研究提出的同軸顯微鏡設計提供了良好的光斑質量和信噪比,可定位工作電流低至10-10A的晶片內部工作區域,圖4為針對某電路功能單元的定位結果,而相同功能的光發射顯微鏡只能定位該晶片5×10-4A的工作區域。此外,研究團隊依託自主研發的電光探針測試裝備,探究器件電光訊號的產生機制並提出一個理論模型,可精確計算器件內部節點的電壓資訊(圖5),模型計算結果和試驗結果吻合較好。相關研究成果發表在Electronics Letters和Applied Sciences上。

圖2.利用鐳射熱激發缺陷定位裝備定位的某微控制器失效點(a)背部紅外相機成像示意圖(b)失效點的具體位置(c)掃描過程中電流的變化情況
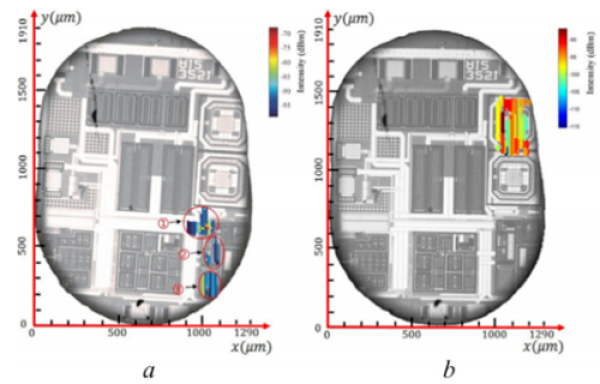
圖4.a、某器件傳送電路定位結果,b、某器件接收電路定位結果
來源:中國科學院國家空間科學中心