來源:內容由半導體行業觀察(ID:icbank)綜合自semiconductor-digest,謝謝。
據外媒semiconductor-digest報道,過去幾個月發生了一系列有趣的事件,首先是在 7 月的英特爾加速活動上宣佈亞馬遜將成為英特爾代工服務 (IFS) 的首批客戶之一,特別是在封裝方面。
11 月 30 日至 12 月 3 日,亞馬遜舉行了他們的AWS re:Invent聚會,他們在會上推出了 Graviton3 資料中心處理器。與早期的 Graviton 和 Graviton2 器件不同,Graviton3 採用小晶片路線,具有 7 個裸片和總共 550 億個電晶體。

核心處理器晶片側面的晶片是DDR5記憶體控制器,底部是 PCI-Express 5.0 控制器晶片。據稱採用的是臺積電5nm工藝,執行頻率為2.6GHz,功耗為100W,略低於Graviton2的110W。似乎有 500 億個電晶體位於處理器晶片中。
該處理器有 64 個核心與一個執行在 >2 GHz 且頻寬超過 2 TB/s 的網格縫合在一起。32 MB 的快取記憶體分佈在網格中,與核心快取一起,晶片上的快取增加到 100 MB。DDR 控制器為 DDR4800,提供超過 300 GB/s 的記憶體頻寬。

鑑於 Graviton3 封裝的外觀以及 Amazon/Intel IFS 封裝宣告,我懷疑這些小晶片是否與英特爾的 EMIB(嵌入式多晶片互連橋接)技術相關聯。二加二可以得到 22,但在英特爾的最後一個季度電話會議中,我們有評論說,自 3 月以來,他們已經出貨了第一批 IFS 封裝單元以獲取收入。Graviton3 部件現在可用於預覽新的 Amazon EC2 C7g 例項,因此它們顯然存在於 AWS 伺服器中。
對我來說,最後一個確認連結是互連凸塊間距據報道為 55 µm;這就是EMIB使用的。
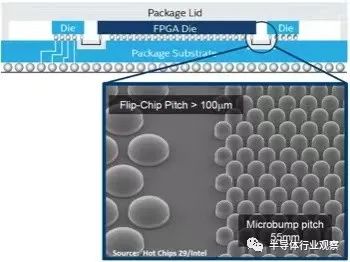
所以,二加二仍然可以得到 22,但在我看來,Graviton3 至少有可能使用 EMIB 將這些小晶片連線在一起,而 AWS 是 IFS 的第一個收入客戶。
英特爾EMIB封裝深度解讀
低成本異構多晶片封裝(multi-chip packaging:MCP)的發展推動了重大的系統級產品創新,進而出現了三類MCP產品:
- 晶圓級扇出重新分佈,使用模塑膠的重構晶圓基板作為裸片之間互連的表面(2D)
- 用於重新分配的單獨的基於矽的互連層,可以是嵌入有機封裝(2.5D)中的全尺寸矽中介層或die到die的矽橋
- 垂直堆疊的面對面或背對背晶片,利用晶片焊盤的混合鍵合和直通孔(3D)
2.5D解決方案已獲得了可觀的研發投資,以支援更大的封裝尺寸和更大的互連重新分佈密度(即,線+間距,金屬層數)。多個較小裸片的整合提供了晶片和封裝組裝的良率和成本的權衡。
2.5D MCP中整合的功能已經變得越來越多樣化,例如,CPU,GPU,記憶體(尤其是HBM堆疊),FPGA,網路交換機,I / O收發器,用於特定應用的硬體加速器。當前的研發工作將繼續擴大這種系統級封裝組成的廣度。下一個“大事”很可能是光電轉換元件的整合,從而實現中短距離的基於光子的資料傳輸效率通道。
支援2.5D MCP產品增長的一個關鍵方面是封裝中裸片之間的內部連線技術。如上所述,一種替代方法是在矽中介層上製造導線,該中介層的尺寸等於整個封裝的尺寸。近期的發展使內插器(interposers )的裸片放置和互連能力超過了最大標線片尺寸(reticle size)的1倍。另一種方法是製造用於導線的小矽橋,該橋跨接在相鄰de的邊緣中,並嵌入有機封裝中。
英特爾的嵌入式多晶片互連橋(Embedded Multi-Die Interconnect Bridge:EMIB)是2.5D MCP橋互連技術的一個示例。在先前的SemiWiki文章中已對此進行了簡要描述。
隨著最近對Intel Foundry Services的重新引入,我認為應該更深入地研究該技術,因為它無疑將成為ICF客戶系統實施的基本組成部分。
在與封裝和測試技術開發部門的英特爾研究員Ravi Mahajan進行的最啟發性的討論中,我有機會了解了更多有關EMIB功能和潛力的資訊。本文總結了我們討論的重點。
EMIB的製造

上圖顯示了設計在有機封裝中的典型EMIB橋的橫截面。橋接矽位於封裝腔中,如下圖所示製作。頂部封裝金屬層提供了一個參考平面,並帶有穿過該平面的通孔,用於連線die和橋。
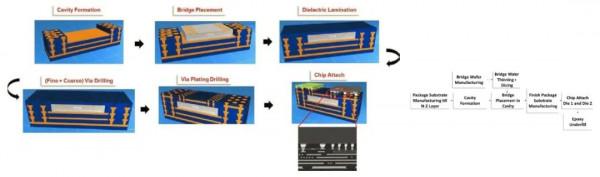
Ravi表示:“ EMIB工藝建立在標準封裝構造流程的基礎上,並附加了建立EMIB腔的步驟。橋位於空腔中,並用粘合劑固定在適當的位置。新增最後的介電層和金屬堆積層,然後進行通孔鑽孔和電鍍。”
請注意,在上方的橫截面圖中,粗孔和細孔分別對應於每個die上存在的兩個不同的凸點間距,如下所示。
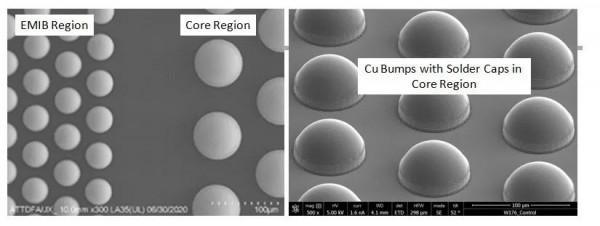
粗大的凸塊用於die到封裝的走線層連線,而細間距則與EMIB連線相關聯-短期內更多關於目標EMIB連線密度的資訊。
Ravi補充說:“進行了大量的工程設計,以定義精細和粗糙的凸點輪廓,這些輪廓將支援管芯附著和透過連線處理。具體而言,這包括重點關注凸塊高度控制和焊料量。我們已經與bumping 供應商合作,以實現這種dual pitch和profile configuration。此外,MCP封裝中的每個裸片都單獨連線-裸片上的凸點將經受多個迴流週期。注意與凸塊結合的助焊劑材料。還已經開發了在整個凸塊區域中提供無空隙的環氧樹脂底部填充劑的方法。材料,凸塊和附著過程都是在大規模生產中進行的。”
EMIB物理實施
下面顯示了一個只做橋的示例。此特定設計實現以下功能:
- 到裸片的凸點間距為55um
- 2um線+ 2um間距,金屬厚度為2um
- 4um間距,每毫米“ beachfront”具有250根導線
- 每個EMIB金屬層之間的電介質厚度為2um
- EMIB橋上的4個金屬層M1和M3專用於GND平面
- 通常在M2和M4上利用3訊號+ 1接地遮蔽圖案的訊號層

確切地說,如下圖所示,備用EMIB層上的金屬平面被實現為網格。
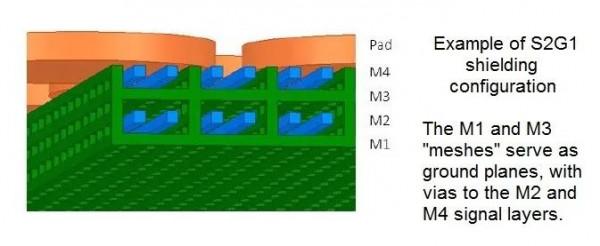
Ravi說:“ EMIB互連的設計是多個目標之間的複雜權衡–互連密度(每毫米邊緣的導線數,每毫米的凸點** 2),功率限制和訊號頻寬。對於每個裸片,這意味著驅動器尺寸和接收器靈敏度。為了節省功率,通常使用無端接的接收器(即,僅容性負載,無電阻端接)。為了解決這些目標,EMIB設計考慮因素包括線和空間尺寸,凸塊間距,溝道長度,金屬厚度以及金屬層之間的介電材料。電訊號遮蔽(例如S1G1,S2G1,S3G1)的設計也至關重要。”
下圖顯示了互連密度設計的佈局圖,包括電橋訊號如何到達相鄰die上的多行細間距凸點。下表說明了可用尺寸和間距的範圍。
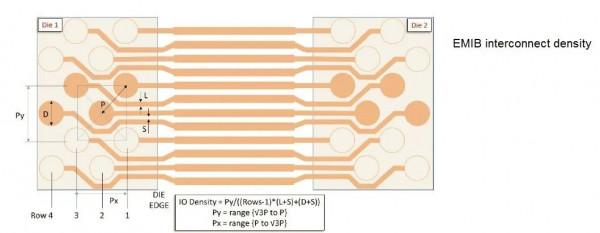

下圖顯示了各種橋定位選項。請注意,橋的放置具有很大的靈活性-例如,水平和垂直方向,相對於模具邊緣的不對稱位置。
EMIB電氣特性
英特爾針對EMIB互連發布了詳細的電氣分析,評估了各種訊號接地遮蔽組合和導線長度的插入損耗和串擾。

上圖突出顯示了封裝中的配電路徑(power distribution paths )。請注意,EMIB橋的佔位面積小,這意味著I / O訊號和電源完整性特性的平衡不會受到影響,這與全矽中介層不同,在矽中介層中,所有訊號和電源過孔都必須首先穿過中介層。如前所述,EMIB上方的頂層封裝層也用作接地層。
下圖顯示了電分析結果的示例,描述了針對各種訊號遮蔽模式的目標累積海灘前頻寬的最大EMIB訊號長度。在此示例中,採用了激進的L / S線距設計。使用的電氣模型:
- 一個簡單的輸出驅動器(R = 50ohms,C = 0.5pF)
- 無端接的接收器(C = 0.5pF)
- 四層EMIB金屬疊層,介電常數= 4.0
- 嵌入式橋上方的頂部封裝金屬平面
- 1V訊號擺幅,具有200mV垂直睜開的接收器靈敏度(為無端接的電容式接收器合併了近端和遠端串擾)
EMIB設計服務
由於EMIB設計權衡的複雜性,Ravi表示:“英特爾將與代工客戶在產品需求方面緊密合作,並將EMIB設計作為一項服務進行開發。我們將與客戶一起在die引出線和凸點圖案上進行合作,並提供可滿足其資料速率目標的EMIB矽實施方案。”
EMIB未來發展
EMIB技術仍然是英特爾的研發重點。Ravi強調說:“我們將繼續致力於提供更大的互連邊緣密度,包括更緊密的凸塊間距和更積極的線/空間EMIB金屬間距(小於1um)。將有源電路整合到EMIB中當然也是可行的。”
總結
支援高階MCP技術的EMIB橋接方法具有一些獨特的優勢:
•現有有機包裝技術的擴充套件
•支援大晶片數和大封裝配置
•比全尺寸矽中介層的成本更低
•使用簡單的驅動器/接收器電路,支援相鄰晶片之間的高資料速率信令
•透過為該連結定製橋來分別最佳化每個沖模-骰子連結的能力
EMIB鏈路具有高能效,低金屬R * C延遲,最小延遲和高訊號完整性。
英特爾研發團隊已解決了EMIB的一些缺點:
•晶片凸塊和封裝組裝過程中的額外複雜性
•封裝,die和EMIB橋之間的熱膨脹係數(CTE)係數不同
EMIB矽在封裝組裝之前變薄(t <75um),因此不會顯著改變封裝和管芯以及凸點和底部填充介面之間的熱機械應力。總體可靠性可與傳統有機包裝媲美。
英特爾代工廠服務的封裝團隊提供的支援將幫助尋求高階MCP解決方案的客戶實現其信令資料速率,功耗和成本目標。
毫無疑問,MCP封裝採用率的增長將繼續加速。(DARPA CHIPS計劃還將使人們對MCP設計產生更大的興趣。)
原文連結:
https://www.semiconductor-digest.com/amazon-aws-is-intel-foundry-services-first-emib-packaging-customer/
*免責宣告:本文由作者原創。文章內容系作者個人觀點,半導體行業觀察轉載僅為了傳達一種不同的觀點,不代表半導體行業觀察對該觀點贊同或支援,如果有任何異議,歡迎聯絡半導體行業觀察。
今天是《半導體行業觀察》為您分享的第2948內容,歡迎關注。
晶圓|積體電路|裝置|汽車晶片|儲存|臺積電|AI|封裝